5G通讯是依靠半导体材料和器件,实现无线电磁波远距离传输、收发、处理的通信技术。相比传统4G移动通信技术,5G需符合全频谱接入、高频段乃至毫米波传输、高频谱效率三大基础性能要求,因此对器件原材料也提出了更高的性能和升级的需求,例如大规模集成化,材料具有高介电常数、低介电损耗和高电子迁移率等。高分子材料凭借其质轻、耐腐蚀、易加工、易改性等诸多优点,在5G材料应用中具有举足轻重的地位。
高分子材料在5G领域中的应用
为满足5G通讯超高速信号传输、超低延迟与多用户接入等特征,5G通讯领域所适用的高分子材料需要具有低损耗、3D可折弯、低介电损耗、散热性能佳等特点。
1.基站外壳
5G基站作为5G网络的核心设备,具有小而密的特点。这些小型的基站外壳可以利用复合材料制造,满足长期放置于室外,面临风吹雨打,光照低温等耐候性要求。这些要求,片状模塑料(SMC)、团状模塑料(BMC)的模压,甚至长纤维增强热塑性材料(LFT)的注塑,都可以满足。关键是哪种原材料和制备工艺可以在满足要求的情况下尽可能的低成本、高效率的实现。
2.天线罩
由于5G天线遵循MIMO(Multiple-Input Multiple-Output)概念,即多输入多输出,这意味着一个基站内可安装多个天线。因为天线制备的精细化和小尺寸的特性,为避免其在恶劣环境中(暴风雨、冰雪、沙尘以及太阳辐射等)受到损害,需要天线罩来进行保护。此外,天线罩也应具备良好的电磁波穿透特性、较强的机械性能等,同时也要求其在工作频率下的介电常数和损耗角正切要低。
天线罩可分为充气型与刚性型两类。一般而言,充气天线罩常用涂有海帕龙橡胶或氯丁橡胶的聚酯纤维薄膜;刚性天线罩常用玻璃纤维增强塑料,夹层结构中的夹心多用蜂窝状芯子或泡沫塑料。随着5G通信网络时代的到来,出现了一些性能优越的复合材料,这些复合材料经久耐用且透波效果非常好,并在绝缘防腐、防雷、抗干扰等诸多领域成就斐然,成为备受欢迎的天线外罩材料。
3.天线
天线在5G网络中的作用将越来越重要,发展前景可期。以智能手机为例,由于行业和市场的快速发展,人们对手机外观设计的一体化及小型化、轻薄化要求越来越强烈,因此需要内部电路的高度集成化。但这对于天线的设计增加了极高的难度。现阶段手机的天线已从早期的外置天线发展为内置天线,同时软板基材制备已成为主流工艺,约超过7成。
目前而言,市场上手机天线软板基材主要是聚酰亚胺(PI),但鉴于PI基材介电常数和损耗因子较大、高频传输损耗严重及结构特性较差,且进行固化之后孔洞缝隙较多容易吸潮,使其不能很好地满足5G时代对材料性能的需求。就目前应用于射频装置中的FR4材料和聚酰亚胺而言,因为孔隙过多吸水潮解这一缺陷,导致其在微波/毫米波频率范围内的介电性能明显下降。因此,有效解决PI固化后孔隙率增多这一现实问题,具有重大的应用意义。此外,除介电特性外,用于5G天线的合适基板材料还应表现出良好的可加工性。
液晶聚酯(LCP)是20世纪80年代初期发展起来的一种新型的特种工程塑料,也是一种耐高温有机热塑性塑料。凭借其优越的结构特性,即分子主链上带有大量的刚性苯环结构,表现出超低的吸湿性、良好的机械性能以及柔韧性等优越性能。更重要的是,LCP在从整个射频(RF)到110 GHz的宽频率范围内都显示出相当稳定的介电常数及较低的损耗角正切值,数值分别为3.0和0.004。基于此优点,LCP被公认为制造在微波/毫米波频率范围内工作的天线的理想基底材料。
虽然LCP具备诸多优点,但在实际应用中也面临不少挑战,如价格非常昂贵、产能不足、制造困难等。配方经过改进的聚酰亚胺(MPI)作为非结晶性材料,操作温度宽、在低温压合铜箔下容易操作,表面易于和铜相接,且价格相对较低。同时,MPI软板的介电常数、吸湿性和传输损耗都介于PI软板和LCP软板之间,随着工艺的改进,在中低频段性能与LCP几乎比肩,且价格相对LCP便宜。因此,MPI材料也可能成为5G设备中大受欢迎的天线材料。
在今后较长的一段时间内,LCP与MPI将处于一种共存的状态,于不同频段中采取不同材料,如中低频段采用MPI材料、高频段采用LCP材料,以达到最佳效果。
4.PCB高频基材
高频PCB印刷电路板作为电子材料器件化的核心设备,对原材料的各项性能要求十分严苛,例如介电常数小且稳定,与铜箔的热膨胀系数相差小甚至达到基本一致,耐热性能佳、抗化学性良好,冲击强度与剥离强度优良,以及吸水性低,旨在尽可能降低受潮对介电常数与介质损耗方面的影响。表1列举了常用的PCB印刷电路板的树脂材料及相关性能。由表可知,聚四氟乙烯(PTFE)、碳氢化合物树脂、PPE树脂等基材所用树脂材料的介质损耗角正切最小,可应用于微波/毫米波领域。因此,在5G通讯领域,目前主流高频基材是PTFE及碳氢化合物树脂材料,其他高频基材还包括聚苯醚改性环氧树脂、氰酸酯改性环氧树脂等。
热塑性材料PTFE具有耐高温的特点,使用工作温度达250℃,在较宽频率范围内的介电常数和介电损耗都很低,而且击穿电压、体积电阻率和耐电弧性都较高,表现出稳定的温度特性和好的电气特性,因此PTFE很适合应用于高频毫米波多层板,是理想的PCB板材料。同时,为了满足更苛刻的使用环境,PTFE还可通过添加各种形式的填料(如玻璃纤维或陶瓷材料)加固增强及改善材料的热膨胀系数。

5G高分子材料的发展趋势
5G高分子材料按功能可分为透波复合材料、导热复合材料、低介电材料和电磁屏蔽材料等。
1.透波复合材料
透波材料是最近十年来快速崛起的一类功能介质材料,包括有结构特性、耐热特性、透波等多方面优势。通用透波复合材料大体可分为树脂基复合材料与无机非金属基复合材料两类。其中,树脂基透波复合材料是由增强纤维和树脂基体构成。通常,增强纤维的力学性能和介电特性均优于树脂基体,因此复合材料的透波性能主要取决于树脂基体的本征性能。可见,选择具有优良电性能的树脂基体至关重要。同时,树脂在复合材料中也起胶粘剂的作用,是决定复合材料耐热性的基本成分。
树脂基体主要包括传统的不饱和聚酯树脂(UP)、环氧树脂(EP)、改性酚醛树脂(PF),以及近年来开始研究和应用的氰酸酯树脂(CE)、有机硅树脂、双马来酰亚胺树脂(BMI)、PI和PTFE等新型耐高温树脂。增强体目前大多采用玻璃纤维,而国内透波复合材料使用的增强材料主要是E玻璃纤维和S玻璃纤维,而M玻璃纤维使用量较少。
Kevlar(芳纶)最初由美国杜邦公司发明,在高性能天线罩的制造中具有极大的吸引力。但未来国防军工的要求也会越来越严苛,对天线罩的要求也日渐上升,但现阶段透波复合材料研究情况仍不容乐观。例如,EP仍是国内外军用航空领域的主体树脂基材,但其耐热性达不到要求,虽经时间打磨与研究,但水平仍然处于中下游。PI具有较好的耐热性,在透波复合材料领域极具发展潜力,但其工艺流程繁琐复杂,在广泛应用上存在困难阻力。当前国外基于PI的透波材料有AFR-7000和PMR-1S等,国内仍在研发阶段。此外,在克服树脂基材纯度问题上国内外研究程度相当,但在突破介电常数与低损耗角正切值上国内仍需进一步改进。
近年来,新兴应用的树脂基体CE,作为一类性能优异的热固性树脂,具有优良的介电性能、力学性能,玻璃化转变温度更是高达415℃。目前国外大量科研人员正在对CE透波材料进行调研,并且多家公司也已深入到研究应用阶段。但国内对于此类氰酸酯树脂的研究仍处于基础起步状态。由此可见,我国在透波复合材料领域的研究仍面临着巨大的挑战。
2.导热复合材料
伴随着高频率、硬件零部件的升级,以及联网设备和天线数量的成倍增长,设备与设备之间及设备本身内部的电磁干扰无处不在,电磁干扰和电磁辐射的影响对电子设备的危害也日益严重。与此同时,电子产品的不断升级换代,器件逐步小型化、轻薄化,使得设备的功耗不断增大,发热量也随之快速上升,越来越严重的散热问题需要得到解决,所以研发制备性能稳定的高导热复合材料成为了一项重要课题。
目前广泛应用的导热材料有合成石墨材料、导热填隙材料、导热凝胶、导热硅脂、导热橡胶和相变材料等。同时具备更优越散热效果的复合型和多层高导热膜也被大众所采用。但是目前制备高导热复合材料的主流技术仍是于高分子基体材料中填充导热填料。
目前看来,引入高导热率的填隙材料能够有效提升材料整体的导热性能,但对基体材料性能的维持,以及填隙材料的填充量、种类、尺寸等诸多因素,也限制着高导热复合材料的进一步发展。目前高导热材料行业中一直不乏有导热橡胶、导热凝胶、导热硅脂作为基体材料的身影。
碳系家族中有着众多性能优良的填料,如石墨烯,其理论其导热系数高达5300W/(m·K),明显优于市场上的大量填隙材料,因此将其作为一种理想的导热填料导入基体材料中,可在一定程度上提高导热性能。另外,独特的二维结构使其具有极高的导热系数和优异的机械性能,在国内外众多领域中更是熠熠生辉。但不足之处在于,自身电导过高,容易限制其在绝缘领域的应用范围。

随着应用领域的多元化,需求开始从整体材料的高热率转换到特定方向上提高热导率。然而,材料的高热导率方向与复合材料的最高热导率方向并不一致,这样一来对材料的设计提出了更加严苛的要求,也带来了许多困难。所以,在未来导热复合材料的科学研究上可更多关注特定方向实现高热导。由此可见,现阶段高分子材料导热聚合物的理论发展相对于工业实际应用已经出现滞后现象,研究方向与实践也面临着诸多挑战,解决问题已刻不容缓。但同时,这也对导热复合材料在5G领域的应用起到了极大的推动作用。
3.低介电材料
随着5G通信系统的迅猛发展,为了实现高信号传输速率、低信号延迟及高信号保真度,在微电子设备集成电路中迫切需要高性能的低介电损耗、低介电常数的电介质材料。通常低介电材料可分为有机低介电材料与无机低介电材料两类。
一般来说,传统上用作层间电介质的材料是无机材料,例如氧化硅和氮化硅。但无机低介电材料脆性大,加工难,限制了其进一步广泛应用。而有机低介电材料中的低介电聚合物不但具有良好的柔韧性,还具有介电常数低的优点,例如聚四氟乙烯的介电常数最低(k≈2),脂肪族聚合物(例如聚乙烯)也表现出低介电常数(k≈2.3)。因此,聚合物是高速通信网络应用中非常有吸引力的潜在材料。此外,ε≈2.5的聚合物会使信号传输速度提高约1.6倍,这也为5G技术的实现带来了相当大的优势。
除介电性能外,低介电材料还需要满足的性能是热稳定性,而这对于聚合物来说恰恰是难题。除此之外,低介电聚合物用作层间电介质还需达到一系列指标,详见表2。
目前常用的低介电聚合物材料主要有PI、聚苯并恶唑、聚芳醚类树脂、全氟化脂族聚合物等。但现阶段能够较好应用于电子材料领域的低介电聚合物并非多数,原因在于原材料的耐高温性不够,玻璃化转变温度范围相对较低,无法很好地满足应用要求,所以对于低介电聚合物的研究问题仍存在空白区域,亟待突破。但国内外科学研究人员并未放弃对低介电常数聚合物的挖掘与探索,通过不同途径合成的低介电常数聚合物的新闻也相继被报道。因此,虽面临困难,但其广阔的应用前景已呈现于眼前。
4.电磁屏蔽材料
5G时代对基站的无缝和深度覆盖必将以前所未有的规模加剧电磁干扰(EMI)和辐射。因此,EMI屏蔽材料将迎来前所未有的新机遇,并成为电子材料乃至未来新材料的重要组成部分。
作为常规的屏蔽材料,金属表现出足够的抗电磁干扰能力。但是,自然的膨松度,难以加工,易腐蚀以及较差的机械柔韧性限制了这些材料在电子通信领域的应用。相应地,聚合物因具有重量轻、柔韧性好、成本效益高、易于加工和耐腐蚀等特点已经成为电磁屏蔽的新兴材料。迄今为止,在主要包括聚合物复合材料和聚合物衍生物的聚合物基EMI屏蔽材料的制造和表征方面已经取得了显著进展。目前基于聚合物的屏蔽材料不仅吸引了知识界的关注,而且迎合了大众市场的需求,它产生了许多屏蔽产品,如导电涂层、导电胶、导电布、导电泡沫、导电垫片和透明导电膜等。
目前聚合物基EMI屏蔽材料在结构上可分为均匀结构、多孔结构、层状结构和隔离结构等。均匀结构是一种基本设计策略,旨在使引入的填料在EMI屏蔽聚合物复合材料中均匀分布。分散在整个聚合物基体中的填料相互重叠,形成导电网络。理想情况下,填料的均匀分散使复合材料具有各向同性的特征。然而,混合的填料可能以不同的比例以不同的尺寸存在,并且填料的含量通常很高(>5wt%),这使得填料易于在聚合物基体中附聚,从而严重影响复合材料的性能。分散性的改善可以通过外力的干预和内部填料的改性来实现。值得注意的是,均匀结构由于其易于操作而在商业领域中广受欢迎。目前获得均质结构的方法包括熔融共混、溶液共混和原位聚合等。
聚合物衍生物作为EMI屏蔽材料主要是将聚合物前体进行碳化或热解从而用于EMI屏蔽。碳材料因其先进的导电性、高表面积、自然轻质、环境友好和化学稳定性而被认为是EMI屏蔽的最佳选择。聚合物,包括合成聚合物和生物聚合物,凭借其可碳化和可石墨化的特性,可以作为碳材料的来源,为先进的全碳EMI屏蔽材料提供了工业上可行的方法。
EMI屏蔽材料未来主要向屏蔽效能更高、屏蔽频率更宽、综合性能更优、材料多元化,产品种类不断丰富和创新,以及工艺的不断升级等方向发展。
芳腈基树脂在5G领域的应用
芳腈基聚合物是一类同时具有芳香环和氰基的聚合物,主要分为两大类:聚芳醚腈和邻苯二甲腈树脂。芳腈基聚合物具有耐高温、阻燃性好、高强度、高模量、耐腐蚀、耐辐照和高频传输稳定等优异性能,有望在5G天线罩、PCB高频基材等领域得到广泛应用。
1.聚芳醚腈
聚芳醚腈是类分子链上含有氰基侧基的聚芳醚类热塑性高分子(结构通式见图1),因特殊的分子结构(含有刚性基团、耐热性的亚苯基及柔性、耐热性的氧醚键或硫醚键),表现出高耐热、抗蠕变、高强度、高刚性、强韧性和优异的电性能等突出特性。通常在二卤苯甲腈与芳香二元酚在碱的催化下,通过亲核取代反应获得聚芳醚腈及其共聚物。其性能可通过调节二元酚的结构进行调控,表3列出了几种典型聚芳醚腈的热学和力学性能。

聚芳醚腈由于氰基侧基的存在,在高温下可发生交联反应形成结构稳定的三嗪环,使聚芳醚腈由线性结构向体型结构转变,玻璃化转变温度可高达386℃。因此,聚芳醚腈的电性能具有非常优越的温度稳定性。同时,聚芳醚腈分子链侧面的氰基是一个强极性基团,使其与铜箔具有良好的粘接性,为其在5G高频覆铜板领域的应用提供了可能。
童利芬等人成功地合成了一种新型的羟基封端的含氟聚芳醚腈(PEN-OH),并研究了热处理温度对PEN-OH薄膜的热性能、力学性能和介电性能的影响。由于在高温下PEN-OH主链上的氰基侧基之间发生交联反应生成结构稳定的三嗪环,因此材料的结构从线性结构变为体型结构,从而改善了其热性能和机械性能。另外,发生交联反应可减少材料中的极性基团,导致介电常数降低。随着热处理温度的升高,玻璃化转变温度从180.6°C升高至203.6℃,介电常数从3.4降低至2.8。此外,由于PEN-OH对铜箔具有优异的粘合性,因此通过简单的热压法制备了不具有粘合剂的双层柔性覆铜层压板(FCCL),该双层FCCL具有1.01N/mm的高剥离强度。
富勒烯因其特殊的空心笼结构而被广泛用于降低复合材料的介电常数。然而,实现其材料潜在应用的主要挑战是提高聚合物基质与富勒烯之间的界面相容性。雷晰婷等人通过共溶剂蒸发的物理方法,制备了具有优越的填料分散性的聚芳醚腈/富勒烯复合膜,可用于制造柔性印刷电路板。当富勒烯含量为3 wt%时,薄膜在1 MHz时具有最低的介电常数(2.65),通过Flynn-Wall-Ozawa方法测得的使用寿命为3.3年。此外,当复合膜用于FCCL时,树脂与铜箔之间的180°剥离强度为6.91N/cm。因此,这种PEN/富勒烯复合材料成为制备FCCL的潜在原料。
2.邻苯二甲腈树脂
邻苯二甲腈树脂是一类具有邻苯二甲腈官能团的热固性树脂,双邻苯二甲腈树脂的结构通式如图2所示。在过渡金属、金属盐、活泼氢化合物等催化剂存在下,双邻苯二甲腈官能团可在高温下发生聚合反应,生成三嗪环、异吲哚环、酞菁环和脱氢酞菁环等杂环结构。因此,邻苯二甲腈固化物表现出优越的耐高温、自阻燃、高强度、耐腐蚀等性能。
表4对玻纤增强双邻苯二甲腈树脂与玻纤增强环氧改性双邻苯二甲腈树脂的热学、力学和电学性能进行了对比。由表可知,双邻苯二甲腈树脂/玻纤板材的玻璃化温度高达350℃,介电损耗约为0.007,明显优于环氧改性双邻苯二甲腈树脂/玻纤板材,这为其在高玻璃化转变温度高频覆铜板的应用提供了可能。
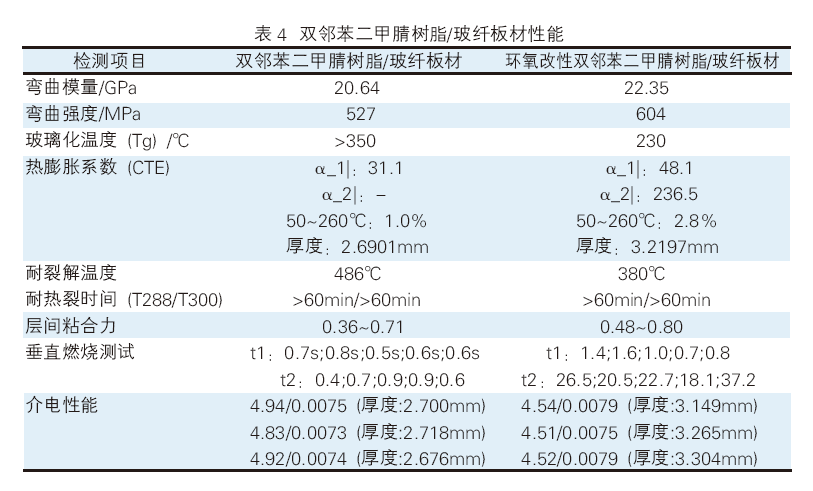
5G高频通讯时代的到来为高分子材料的发展提供了难得的契机。透波复合材料、导热复合材料、低介电材料、和EMI屏蔽材料等高分子复合材料在5G领域具有非常广泛的应用价值。芳腈基聚合物由于其高强度、高模量、耐高温、结构可设计性和金属替代等优点,在5G高频覆铜板、手机后盖、天线模块、滤波器和连接器等相关组件中具有广泛的应用前景。

